集成电路( integrated circuit )是采用多种工艺,把一个电路中所需的晶体管、电阻、电容和电感等元件及布线互连一起,制作在一小块或几小块半导体晶片或介质基片上,然后封装在一个管壳内,实现所需电路功能的微型结构。现代集成电路按功能划分,主要可以分为存储器,处理器,逻辑 IC,模拟 IC 四大类。
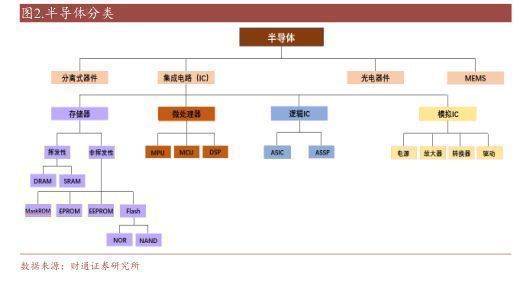
完整的集成电路的制造过程通常分为前道晶圆制造(Front-End)与后道封装(Back-End)两个部分。传统封装(后道)测试工艺可以大致分为背面减薄、晶圆切割、贴片、引线键合、模塑、电镀、切筋成型和终测等 8 个主要步骤。与前道晶圆制造相比,后道封装相对简单,对工艺环境、设备和材料的要求较低。前道晶圆制造的复杂程度要远超后道封装,主要涉及光刻,刻蚀,薄膜沉积,显影涂胶,清洗,掺杂氧化扩散,量测等工艺。其中刻蚀与光刻及薄膜沉积一起,并列为晶圆制造最重要的三大工艺之一。
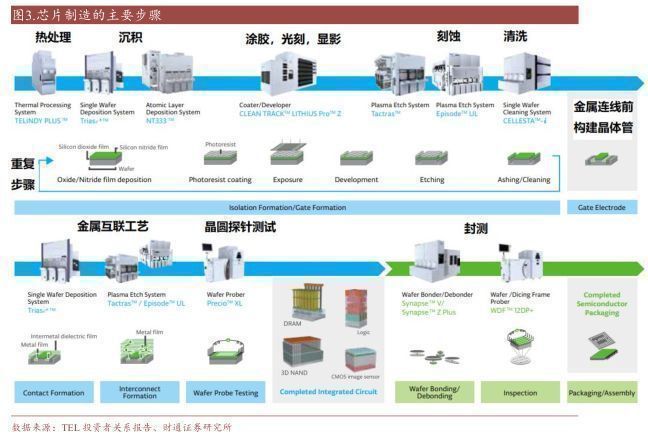
集成电路的构造并非简单的平面图形,而是一层层构造叠加起的立体结构。其中,刻蚀作为核心工艺之一的作用,是通过物理及化学的方法,在晶圆表面的衬底及其他材料上,雕刻出集成电路所需的立体微观结构,将前道掩模上的图形转移到晶圆表面。在刻蚀新形成的结构上,可以进行 2 、SiN 介质薄膜沉积或金属 Al,Cu,W 薄膜沉积,也可以进行多重曝光或下一刻蚀步骤,最终在各个层形成正确图形,并使得不同层级之间适当连通,形成完整的集成电路。
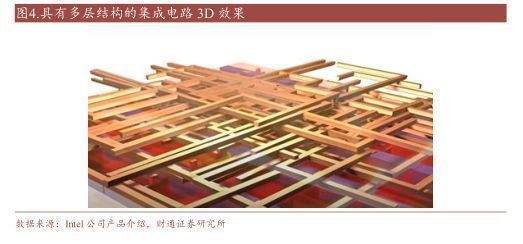
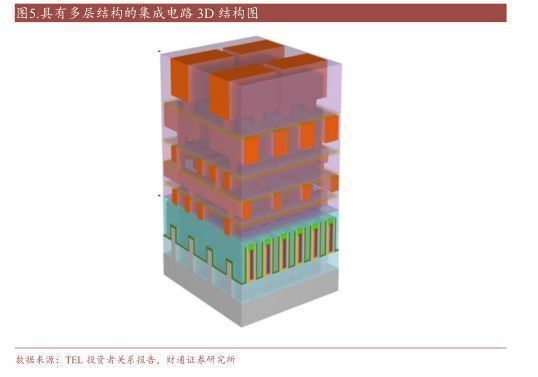
刻蚀设备的重要性不断升高。这是由于光刻设备受到光源波长(DUV 的 193nm 或EUV 的 13.5nm)的限制,分辨率有一定极限;当晶体管微缩到一定尺寸之后,单纯依靠光刻机的精确度推进工艺进步已经非常困难。刻蚀步骤的设备,工艺,核心零部件的行业壁垒很高。这主要是因为:(1)刻蚀作为图形转移的关键步骤,其所需要雕刻出的结构形态各异;(2)刻蚀步骤需要在不同的材质表面进行,其所涉及的工艺方法相差较大;(3)刻蚀作为主要步骤,占用了大量工艺时间和厂房空间,其生产效率和良率,对产线)刻蚀步骤需要射频源,气路,电极,冷热源,真空等多个子系统的精确流畅配合,这需要大量的工艺数据积累。
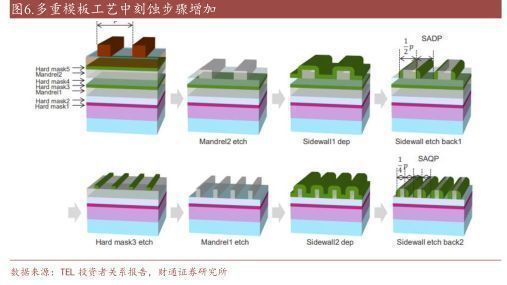

集成电路 2D 存储器件的线宽已接近物理极限。NAND 闪存已进入 3D 时代,目前128 层 3D NAND 闪存已进入量产阶段,196 层和 200 层以上的闪存芯片正逐步放量。3D NAND 制造工艺中,增加集成度的方法不再是缩小单层的线宽,而是增加堆叠的层数。逻辑与 DRAM 集成电路也已遇到物理因素限制,3D 化设计雏形开始浮现。3D 化集成电路对刻蚀设备提出了更高的要求。
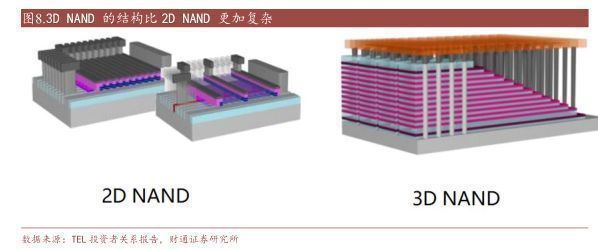
80 年代以后,随着集成电路制程的升级,及芯片结构尺寸的不断缩小,湿法刻蚀在线宽控制,刻蚀方向性方面的局限性渐渐显现,并逐步法刻蚀取代。湿法刻蚀目前多用于回刻蚀,特殊材料层的去除,残留物的清洗。
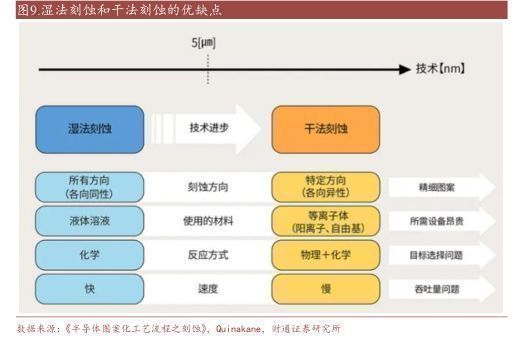
湿法刻蚀是较为原始的刻蚀技术,利用溶液与薄膜的化学反应去除薄膜未被保护掩模覆盖的部分,从而达到刻蚀的目的。其反应产物必须是气体或可溶于刻蚀剂的物质,否则会出现反应物沉淀的问题,影响刻蚀的正常进行。通常,使用湿法刻蚀处理的材料包括硅,铝和二氧化硅等。
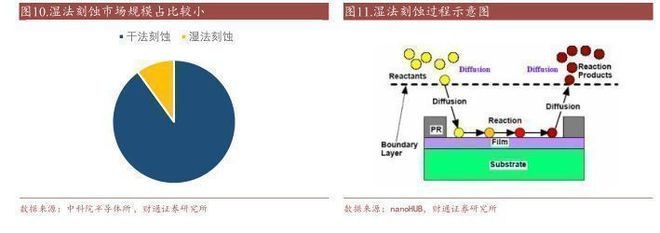
一般采用强氧化剂对硅进行氧化,然后利用氢氟酸与二氧化硅反应,去除掉二氧化硅,达到刻蚀硅的目的。最常用的刻蚀溶剂是硝酸与氢氟酸和水的混合液。此外,也可以使用含 KOH 的溶液进行刻蚀。2 )二氧化硅的湿法刻蚀
二氧化硅的湿法刻蚀可以使用氢氟酸(HF)作为刻蚀剂,但是在反应过程中会不断消耗氢氟酸,从而导致反应速率逐渐降低。为了避免这种现象的发生,通常在刻蚀溶液中加入氟化铵作为缓冲剂,形成的刻蚀溶液称为 BHF。氟化铵通过分解反应产生氢氟酸,维持氢氟酸的恒定浓度。3 )氮化硅的湿法刻蚀
氮化硅是一种化学性质比较稳定的材料,它在半导体制造中的作用,主要是作为遮盖层,以及完成主要流程后的保护层。湿法刻蚀大多用于整层氮化硅的去除,对于小面积刻蚀,通常选择干法刻蚀。4 )铝的湿法刻蚀
集成电路中,大多数电极引线都由铝或铝合金制成。铝刻蚀的方法很多,生产上常用加热的磷酸,硝酸,醋酸以及水的混合溶液。硝酸的作用主要是提高刻蚀速率,醋酸用来提高刻蚀均匀性的。

随着集成电路的发展,湿法刻蚀呈现出以下局限:不能运用 3 微米以下的图形;湿法刻蚀为各向同性,容易导致刻蚀图形变形;液体化学品潜在的毒性和污染;需要额外的冲洗和干燥步骤等。
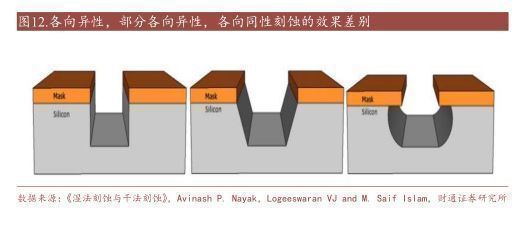
干法刻蚀技术的出现解决了湿法刻蚀面临的难题。干法刻蚀使用气体作为主要刻蚀材料,不需要液体化学品冲洗。干法刻蚀主要分为等离子刻蚀,离子溅射刻蚀,反应离子刻蚀三种,亿博电竞 亿博官网运用在不同的工艺步骤中。1 ) 等离子体刻蚀是将刻蚀气体电离,产生带电离子,分子,电子以及化学活性很强的原子(分子)团,然后原子(分子)团会与待刻蚀材料反应,生成具有挥发性的物质,并被真空设备抽气排出。
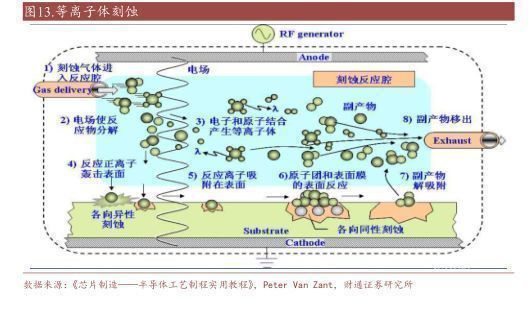
根据产生等离子体方法的不同,干法刻蚀主要分为电容性等离子体刻蚀和电感性等离子体刻蚀。电容性等离子体刻蚀主要处理较硬的介质材料,刻蚀高深宽比的通孔,接触孔,沟道等微观结构。电感性等离子体刻蚀,主要处理较软和较薄的材料。这两种刻蚀设备涵盖了主要的刻蚀应用。
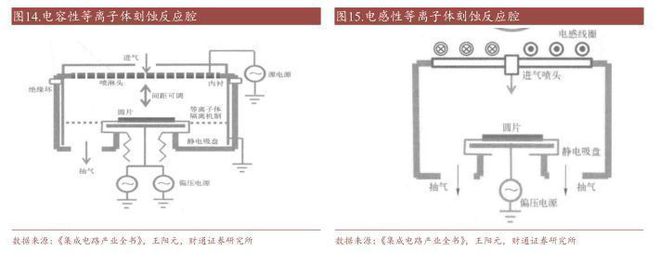
2)反应离子刻蚀(Reactive Ion Etching RIE)通过活性离子对衬底进行物理轰击,同时进行化学反应。它综合溅射刻蚀和等离子刻蚀,同时兼有各向异性和选择性好的优点。先用离子轰击将刻蚀材料表面,将原子键破坏使化学反应增强,再将沉积于被刻蚀物表面的产物打掉。
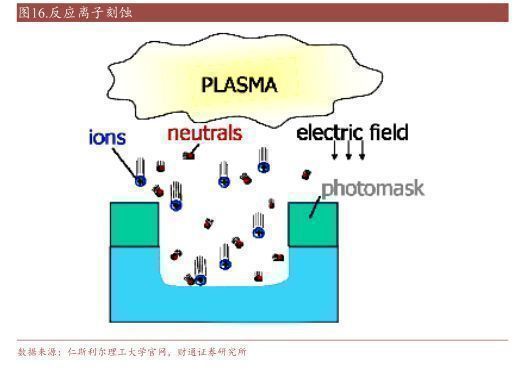
3 )离子束溅射刻蚀又称离子束刻蚀或离子铣。与主要依赖化学反应的等离子体刻蚀系统不同,离子束刻蚀是一个物理工艺。晶圆在真空反应室内被置于固定器上,向反应室导入氩气流;氩气受到从一对阴阳极来的高能电子束流的影响,氩原子被离子化,变为带正电荷的高能状态,被吸向固定器。当氩原子向晶圆固定器移动时,它们会加速冲击暴露的晶圆层,并将晶圆表面轰击掉一小部分。
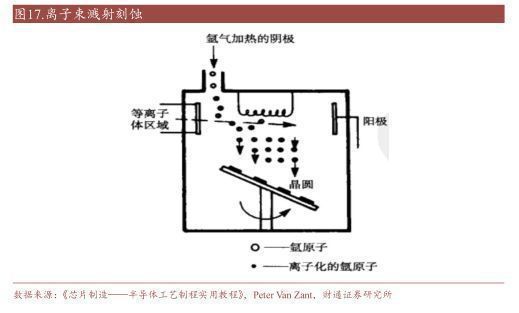

金属刻蚀主要用于金属互连线铝合金刻蚀,制作钨塞;介质刻蚀主要用于制作接触孔,通孔,凹槽;硅刻蚀主要用于制作栅极和器件隔离沟槽。介质刻蚀一般为电容耦合等离子体刻蚀机;硅,金属刻蚀一般为电感耦合等离子体刻蚀机。


电容耦合等离子体刻蚀(CCP)是通过匹配器和隔直电容把射频电压加到两块平行平板电极上进行放电而生成的,两个电极和等离子体构成一个等效电容器。这种放电是靠欧姆加热和鞘层加热机制来维持的。由于射频电压的引入,将在两电极附近形成一个电容性鞘层,而且鞘层的边界是快速振荡的。当电子运动到鞘层边界时,将被这种快速移动的鞘层反射而获得能量。电容耦合等离子体刻蚀常用于刻蚀电介质等化学键能较大的材料,刻蚀速率较慢。2 )电感耦合等离子体 ICP(Inductively Coupl ed Plasma) 刻蚀
电感耦合等离子体刻蚀(ICP)的原理,是交流电流通过线圈产生诱导磁场,诱导磁场产生诱导电场,反应腔中的电子在诱导电场中加速产生等离子体。通过这种方式产生的离子化率高,但是离子团均一性差,常用于刻蚀硅,金属等化学键能较小的材料。电感耦合等离子体刻蚀设备可以做到电场在水平和垂直方向上的独立控制,可以做到真正意义上的 De-couple,独立控制 plasma 密度以及轰击能量。


单晶硅刻蚀用于形成浅沟槽(STI),电容器的深沟槽。单晶硅刻蚀包括两个工艺过程:突破过程和主刻蚀过程,突破过程使用 SiF4 和 NF 气体,通过强离子轰击和氟元素化学作用移除单晶硅表面的氧化层;主刻蚀则一般采用溴化氢(HBr) 为主要刻蚀剂,溴化氢在等离子体中分解释放溴元素自由基,这些自由基和硅反应形成具有挥发性的四溴化硅(SiBr4)。单晶硅刻蚀通常采用电感耦合等离子体刻蚀的刻蚀机。1.3.3. 多晶硅刻蚀
多晶硅刻蚀是最重要的刻蚀工艺之一,因为它决定了晶体管的栅极,而对栅极尺寸的控制很大程度上决定了集成电路的性能。多晶硅的刻蚀要有很好的选择比。通常选用卤素气体,氯气可实现各向异性刻蚀并且有很好的选择比(可达到 10:1);溴基气体可得到 100:1 的选择比;HBr 与氯气,氧气的混合气体,则可以提高刻蚀速率。而且卤素气体与硅的反应产物沉积在侧墙上,可起到保护作用。多晶硅刻蚀通常采用电感耦合等离子体刻蚀的刻蚀机。

金属刻蚀主要是互连线及多层金属布线的刻蚀,刻蚀的要求是:高刻蚀速率(大于 1000nm/min);高选择比,对掩盖层大于 4:1,对层间介质大于 20:1;高的刻蚀均匀性;关键尺寸控制好;无等离子体损伤;残留污染物少;不会腐蚀金属等。金属刻蚀通常采用电感耦合等离子体刻蚀的刻蚀机。1 )铝的刻蚀
铝是半导体制备中最主要的导线材料,具有电阻低,易于沉积和刻蚀的优点。刻蚀铝,是利用氯化物气体所产生的等离子体完成的。铝和氯反应产生具有挥发性的三氯化铝(AlCl3),随着腔内气体被抽干。一般情况下,铝的刻蚀温度比室温稍高(例如 70℃),AlCl3 的挥发性更佳,可以减少残留物。除了氯气外,铝刻蚀常将卤化物加入,如 SiCl4,BCl3,BBr3,CCl4,CHF3 等,主要是为了去除铝表面的氧化层,保证刻蚀的正常进行。2 ) 钨的刻蚀
在多层金属结构中,钨是用于孔填充的主要金属,其他的还有钛,钼等。可以用氟基或氯基气体来刻蚀金属钨,但是氟基气体(SiF6,CF4)对氧化硅的选择比较差,而氯基气体(CCl4)则有好的选择比。通常在反应气体中加入氮气来获得高的刻蚀胶选择比,加入氧气来减少碳的沉积。用氯基气体刻蚀钨可实现各向异性刻蚀和高选择比。干法刻蚀钨使用的气体主要是 SF6,Ar 及 O2,其中,SF6 在等离子体中可被分解,以提供氟原子和钨进行化学反应产生氟化物。
氮化钛硬掩膜取代传统的氮化硅或氧化层掩膜,用于双大马士革刻蚀工艺。传统掩膜和低 k 介电层之间的选择比不高,会导致在刻蚀完成后出现低 k 介电层顶部圆弧状轮廓以及沟槽宽度扩大,沉积形成的金属线之间的间距过小,容易发生桥接漏电或直接击穿。氮化钛刻蚀通常运用于硬掩膜开孔的过程中,主要反应产物为 TiCl4。1.3.5. 介质刻蚀
介质刻蚀以二氧化硅,氮化硅等电介质为主要刻蚀对象,被广泛应用在芯片制造中。电介质刻蚀主要用于形成接触孔和通道孔,用以连接不同的电路层级。此外,介质刻蚀覆盖的工艺步骤还有硬式遮蔽层刻蚀和焊接垫刻蚀(部分)。介质刻蚀通常采用电容耦合等离子体刻蚀原理的刻蚀机。1 )二氧化硅膜的等离子刻蚀
二氧化硅膜的刻蚀通常采用含有氟化碳的刻蚀气体,如 CF4,CHF3,C2F6,SF6 和C3F8 等。刻蚀气体中所含的碳可以与氧化层中的氧产生副产物 CO 及 CO2,从而去除氧化层中的氧。CF4 是最常用的刻蚀气体,当 CF4 与高能量电子碰撞时,就会产生各种离子,原子团,原子和游离基。氟游离基可以与 SiO2 和 Si 发生化学反应,生成具有挥发性的四氟化硅(SiF4)。2 )氮化硅膜的等离子刻蚀
氮化硅膜的刻蚀可以使用 CF4 或 CF4 混合气体(加 O2,SF6 和 NF3)进行等离子体刻蚀。针对 Si3N4 膜,使用 CF4—O2 等离子体或其他含有 F 原子的气体等离子体进行刻蚀时,对氮化硅的刻蚀速率可达到 1200Å/min,刻蚀选择比可高达 20:1,主要产物为具有挥发性,亿博电竞 亿博官网方便被抽走的四氟化硅(SiF4)。1.4. 刻蚀工艺指标复杂,难度大行业壁垒高
刻蚀是光刻之外最重要的集成电路制造步骤,存在多项关键工艺指标,对芯片良品率和产能影响很大。刻蚀设备想要达成相关的工艺指标,则需要长期的实验和跑片来积累经验和 knowhow,并不断调试设备各个子系统的相应参数设置。因此,刻蚀设备行业存在较高的壁垒。1 )刻蚀速率即在刻蚀过程中去除硅片表面材料的速度,实际生产中为了提高产量,需要提高刻蚀速率。在采用单片工艺的设备中,它是一个非常重要的参数。
2 )刻蚀剖面指的是被刻蚀图形的侧壁形状,有两种基本的刻蚀剖面,分别是各向同性和各向异性。各向同性的刻蚀剖面是在所有方向上(横向和纵向)以相同的刻蚀速率进行刻蚀。

人工智能 Ai产业 Ai芯片 智能家居 智能音箱 智能语音 智能家电 智能照明 智能马桶 智能终端 智能门锁 智能手机 可穿戴设备 半导体 芯片产业 第三代半导体 蓝牙 晶圆 功率半导体 5G GA射频 IGBT SIC GA SIC GAN 分立器件 化合物 晶圆 封装封测 显示器 LED OLED LED封装 LED芯片 LED照明 柔性折叠屏 电子元器件 光电子 消费电子 电子FPC 电路板 集成电路 元宇宙 区块链 NFT数字藏品 虚拟货币 比特币 数字货币 资产管理 保险行业 保险科技 财产保险 刻蚀设备
(特别说明:本文来源于公开资料,摘录内容仅供参考,不构成任何建议,如需使用请参阅报告原文。)



 手机:13966668888
手机:13966668888  邮箱:
邮箱:  传真:400-000-0000
传真:400-000-0000  地址:江西省南昌市
地址:江西省南昌市